
欢迎来到「C位」,它是CMC资本团队全新打造的与创业圈、科技产业、学术界分享交流的频道。通过这个窗口,我们关注和记录在当下发生的诸如企业数字化、产业智能化、业务自动化、无人驾驶与智能车、新能源技术、元宇宙等一系列科技领域中的技术前沿、创业实践,以及行业趋势思考,内容形式包括业界对话、行业观察、投资观点等等。我们期望以开放的信息分享和坦诚的观点解构为特色,注重质量,持续输出。
本期「C位观察」由CMC资本投资副总裁赵凡执笔,给大家带来半导体封装领域的主题研究:先进封装的黄金五年。

赵凡 Fan Zhao
CMC资本 投资副总裁
专注投资领域:先进封装、chiplet、存储、DPU、半导体生产设备及材料、CIM
长文预警:本文约4600字,
预计阅读时长:12分钟
先进封装发展前景:天时地利人和

图片数据来源:Yole、Frost&Sullivan、中国半导体行业协会
纵观全球半导体产业转移逻辑,大致是沿着“欧美→日韩台→中国大陆”进行迁移,而封装产业则是半导体产业转移的“前锋”。根据Yole和中国半导体行业协会数据,过去20年,中国大陆在传统封装市场飞速发展,已经占据全球传统封装产业的超过60%。先进封装的产业转移在原有的基础上,有了天时地利人和的优势,特别是在当下的地缘政治因素下,必将在未来的五年内高速发展,根据Frost & Sullivan 预测,2021-2025 年,中国先进封装市场CAGR将为 29.9%,在2021年中国大陆在先进封装领域占全球市场的20%,展望未来五年,市场的高速腾飞已成定局。
天时:先进封装路线的必然性+先进封装产业转移势能
01
随着集成电路先进制程工艺不断微缩,“摩尔极限”这个概念正在被越来越多人所熟知,半导体的行业迭代则需要依赖新的方向。其中一条路是试图对器件结构、沟道材料、制造工艺等领域进一步突破,以实现对摩尔定律的延续,即“More Moore”;另一条路则是需要依赖先进封装技术,在制程不变的情况下,通过高速互联、3D结构等来实现系统的性能突破,实现对摩尔定律的超越,即“More than Moore”,而其中,先进封装这条道路目前已经初显成效。半导体产业转移是行业历史性的周期规律,中国大陆从上个世纪90年代开始承接传统封测的产业转移,目前诞生了长电、通富、华天三家大型封测企业,分列全球封测厂第三、四和第六名[i]。而这三家企业也正在努力迎合先进封装产业发展的时机。
地利:中国芯片市场需求+地缘政治风险
02
中国是全球最大的芯片市场,2021年全球半导体市场销售额总计5,559亿美元,中国以1,925亿美元的半导体销售额占到了34.6%。[ii] 庞大的市场对上游催生了强大的需求,众多厂商蜂拥而至,迅速拉动了大陆半导体,特别是先进封装的产能爬坡。
然而,在中美竞争的大背景下,EUV光刻机等设备的禁令几乎堵死了国产芯片制程的提高,目前中芯国际仅能保证成熟工艺的稳定产能,落后于TSMC数代。在这种状态下,先进封装作为提升性能的另一条路径,由于其工艺精度仅在微米级,并没有被“卡住脖子”,则成为目前国产半导体产业“弯道超车”的捷径。
人和:先进封装方向已成共识+中国先进封装技术人才完善
03
通过过往20年的行业发展,产业的人才逐渐丰富,Fabless设计公司、IDM公司、泛半导体领域中光伏和显示行业中也培养了大量人才,投资机构都逐渐重视先进封装领域,异构整合、异构集成是未来的发展趋势已成共识。于此同时,国内封装设备技术在逐渐突破国外封锁。在后道工艺中,微米级工艺技术掌控和设备国产化率在稳步提升,是促成行业高速发展的关键。在政策的支持下,我国当前先进封装行业发展势头正猛。
趋势1:先进封装技术演进从毫米工艺走向微米工艺,技术趋于IC化
传统封装中,芯片通常被封装在塑料或陶瓷封装体中,并通过引脚连接到电路板上,例如QFN等封装技术,它们有相对成熟和经过验证的技术,引脚密度较低,封装的解决方案是标准化产品,适用于较低集成度的芯片。如果你走进一个传统封装厂,你不会有很强烈的半导体无尘室的感觉。但走进先进封装厂后就不一样了,在百级甚至十级的无尘室中,你可以看到黄光区,产线上有光刻机,有湿法刻蚀等设备,先进封装厂已经悄然的升级成为轻量级foundry。

图:文章作者在英特尔光刻部门的工作照,在光刻机黄光区
两个不可逆因素在推动先进封装的发展:(1) 先进制程的芯片微缩后,芯片面积持续缩小, (2) 芯片复杂程度急速上升,在持续缩小的面积上信号连接点(引脚数量)在急剧上升。先进封装采用了芯片设计思路和先进的集成工艺,对芯片进行封装重构,进一步适应芯片对于集成度、芯片互联能力日益增长的需求,随着技术的不断进步,先进封装在现代电子设备中的应用越来越广泛。随着集成技术不断演进,先进封装的种类和涵义也在持续丰富,而其大致呈现出线路越来越密、集成度越来越高、散热性能越来越好、Chiplet和3D异构集成等结构逐渐完善的趋势,芯片封装的工业逻辑正逐渐从单纯的机械性(Mechanical)概念走向集成电路式(IC-like)的概念。
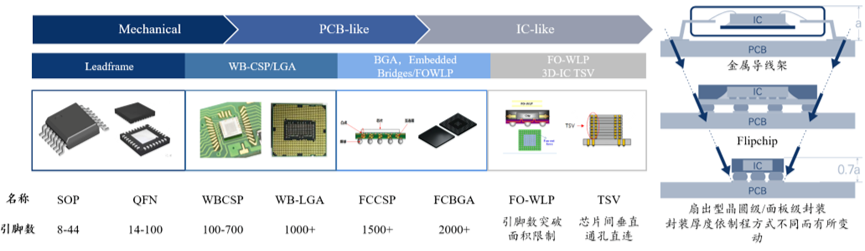
图:芯片封装演进趋势
趋势2:计算中心对大算力芯片的强需求,短期将推动芯片级封装高速发展,并带动载板行业结构性变化
在集成的维度上,先进封装大致存在三种途径:芯片级封装、晶圆级封装和面板级封装。芯片级封装通常是依靠IC载板进行芯片间的集成,依赖载板层数来提供高密度的I/O;晶圆级封装则通过扇出(和扇入)布线,将高密度I/O“摊开”,直接在晶圆上布线并实现芯片集成,这样极大提升了先进封装的效率和集成度;面板级封装则将封装的维度从晶圆扩充到了面积更大的面板,能进一步提升封装效率,但也面临着更严重的翘曲、移位等技术难题。
因为技术方案的差异,利用基板的封装方案发展的最早,成本结构和产业链发展较为成熟,但基板厚度和功耗较高的问题无法满足移动端芯片的封装需求,因此以FCBGA为代表的的芯片级封装方案成为了大算力xPU的主要封装技术平台。晶圆级和板级封装利用更薄更紧密集成的优势,是移动端芯片的主战场。

图:先进封装的主流技术路线及产业链总结
从产业趋势上而言,近年来消费电子市场的疲软仍在延续,半导体行业最显著的增长曲线在于高性能计算领域。这意味着目前消费电子代表的低阶芯片级、晶圆级、面板级封装总体盘子无显著增长,而高性能计算芯片的主流封装方式:FCBGA高阶芯片级封装将仍占据主流,其技术路线将持续迭代,产业发展也将有强劲的动力。
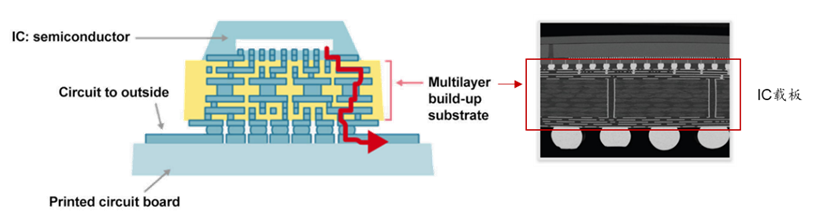
图:IC基板展示[iii]
IC基板是FCBGA封装的核心组件,为IC芯片提供稳定性加固和信号牵引连接,刚性基板在主流上分为BT基板和ABF基板。封装基板随CSP封装(多采用BT基板)的流行应运而生,而BGA封装(采用ABF基板)的出现则进一步提升了基板的价值占比。基板,尤其是ABF基板,短期内作为规模化xPU的关键封装组件的地位难以改变。

图:不同基板的规格、应用各不相同
目前,大陆ABF基板产能正在迅速扩张,国际载板巨头如欣兴、奥特斯等均已在大陆深耕多年,并有扩产计划,而越亚、兴森、深南等基板上市公司和以芯爱、新创元等初创公司都在布局ABF基板产能。预计在2024年下半年开始将有中低端ABF基板(12层以下)产能持续释放到市场中,在2024-2025年之间集中释放,将导致产能过剩,价格下行压力将加剧。但目前仅少数国际厂商具备高阶基板(16层以上)的生产能力,未来大陆高阶基板供不应求的现状仍会持续,高阶基板能力将是行业焦点,行业结构向着高阶基板不断倾斜。
 图:大陆ABF基板厂(部分)分布图
图:大陆ABF基板厂(部分)分布图
趋势3:通过chiplet技术实现多芯片互联是行业的刚需,中国封测厂正在通过性价比更高的技术路径实现2D 2.5D及3D封装
AIGC对先进封装需求的带动作用是无可争议的,而与其直接相关联的封装技术是台积电的CoWoS技术平台,NVIDIA的A100/H100均是采用CoWoS封装技术。野村证券估计,英伟达今年对CoWoS的需求已从今年初预估的3万片晶圆大幅成长50%、达4.5万片[iv],CoWoS产能的稀缺也制约了英伟达的供货节奏。
CoWoS(Chip-on-Wafer-on-Substrate)的的核心思想是将不同的芯片堆叠在同一片硅中介层(Silicon Interposer)实现多颗芯片互联[iv]。在硅中介层中,台积电使用微凸块(ubmps)、硅穿孔(TSV)等技术,代替了传统引线键合用于裸片间连接,大大提高了互联密度以及数据传输带宽,是chiplet范畴中最先进的技术平台。
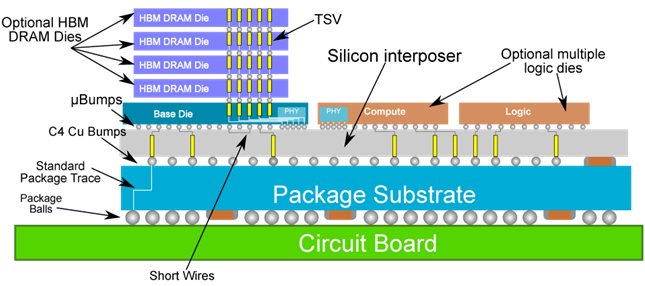 图:台积电CoWoS结构示意图 [v]
图:台积电CoWoS结构示意图 [v]
面临台积电CoWoS产能优先美国芯片大厂向倾斜且成本高昂的限制,中国需要搭建具有更优性价比和更高稳定性的先进封装技术平台,来打通中国Chiplet的链条。我们认为,持续推进ABF基板的工艺,并利用基板上布线、嵌入硅桥等方法替代硅中介层实现Die-to-Die互联的2D集成方案将成为最适合本土产业现状的Chiplet方案。
从布线的线宽线距角度来看,基板的性能上限低于硅中介层,但基本可以胜任芯片互联的任务,并且从成本和产能的角度而言都更有优势。但要实现这一技术平台,需要产业各方在技术路径上相互配合,在高速信号传输协议等方面达成产业共识。在海外,Intel与AMD、台积电等合作组建了UCIe产业联盟,旨在统一chiplet之间的互连口,以实现芯片之间的互联互通。中国的chiplet产业联盟也与国内的系统、IP和封装厂商共同合作,共同发布了《芯粒互联接口标准》,初步形成了中国先进封装产业链的chiplet标准。
图片
结束语
图片
大陆未来五年内在先进封装领域的高速发展将为整个集成电路行业注入新的活力,是中国利用自身成熟制程工艺,通过chiplet技术实现多芯片的互联的关键技术路径。FCBGA和对应的ABF基板在大算力时代推动下,持续发展成为主流的封装技术平台,并将持续迭代。CMC资本在高度行业和技术的发展,并在这领域做出自身的布局,利用资本的力量解决集成电路卡脖子的问题。
参考资料:
[i]https://baijiahao.baidu.com/s?id=1764401865376181192&wfr=spider&for=pc
[ii] https://www.colliers.com/zh-cn/research/e22-20220321semiconductor
[iii] https://www.techdesignforums.com/practice/technique/3d-ic-design/
[iv] https://mp.weixin.qq.com/s/P2sbjOL81qgzObVcpFgL0g
[v] https://www.expreview.com/73341.html









